Heatsink/Heat transfer/Thermal VIA
Mindenképp tegyük oda a thermal-VIA-kat, ahol a meleg keletkezik. Ez a legtöbb esetben az IC thermal PAD-jének a közepe, de vannak kivételek. Ahogy megyünk egyre távolabb ettől a pár négyzetmilliméteres régiótól, kb. négyzetes arányban csökken a thermal VIA-k hatékonysága. Egy nagyobb TSSOP28 tok szélén ez sokszor már csak 20%-ra esik vissza, vagyis sokat nem ad hozzá a végeredményhez, cserébe jó sok routing space megy miatta veszendőbe.
Nagy vonalakban egy 0,6 mm átmérőjű VIA, 20 u-nyi rézvastagsággal, 1,6 mm vastag panelon olyan 100 °C/W termikus ellenállással bír (thermal resistance). Az általánosabban használt 0,3 mm-es VIA közel a duplája ennek. Ebből ha beteszünk tízet (0,3 mm-es), máris 20 °C/W-ra csökken az összérték, de csak elméletben. Ehhez minden thermal VIA-nak a hőforrás közvetlen közelében kellene lennie, amit a jelenlegi tér-idő struktúra nem támogat. A nem pontosan a hőforrás alatt lévő VIA értékéhez egyből hozzáadódik az odáig vezető vékonyka kis rézfólia termikus ellenállása is. A lényeg, hogy pakoljuk őket a lehető legközelebb a hőforráshoz, akkora számban, ami még értelmesnek tűnik. A félvezetőink meghálálják, ha csak 10-20 fokkal is alacsonyabban tartjuk őket. Magában a készülékházban (T_amb) ettől még ugyanúgy, mondjuk 65 °C lesz, mert ugyanannyi hőmennyiség keletkezik, de maga a V_reg belül (T_junction, tulajdonképp a szilícium hőmérséklete) pl. 115-ről lemegy 95 °C-ra. Kisebb átmérőjű VIA-kból többet rakva kisebb lesz a hőellenállás egységnyi felületen.
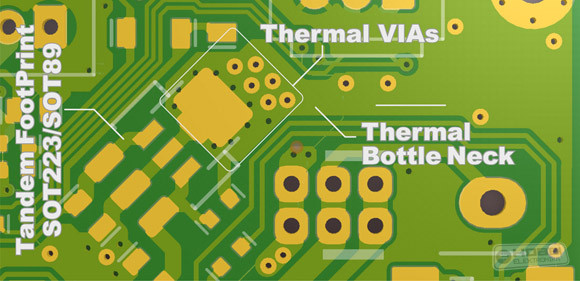
Ha az ültetési rétegen eleve nincs érdemi rézfelület, különösen figyeljünk, hogy ne kerüljenek messze a heatsink/thermal VIA-k a hőforrástól. Ilyenkor thermal relief-et se tegyünk a PAD-re, kivéve, ha a VIA-k egy jó része eleve a PAD-en belül van. Ahol elszűkül a rézfelület, ott a hővezetés is csorbát szenved.
A cikk még nem ért véget, lapozz!
Értékeléshez bejelentkezés szükséges!